LG이노텍, 이론만 있었던 ‘구리기둥’ 기판 신기술 최초 개발… “스마트폰 슬림화 핵심 기술”
- 동아경제
-
입력 2025년 6월 25일 15시 12분
공유하기
글자크기 설정
구리기둥 세우는 ‘코퍼포스트 기술’ 세계 최초 개발·양산
동일 기능 기판 크기 최대 약 20%↓
스마트폰 슬림화·고사양화 위한 최적 기술
정밀 설계로 발열까지 개선
문혁수 대표 “고객사 고민에서 시작된 업계 패러다임 전환 신기술”

LG이노텍이 업계 패러다임을 변화시킬 반도체 기판용 혁신 기술을 개발했다.
LG이노텍은 모바일용 고부가 반도체 기판에 적용되는 ‘코퍼포스트(Cu-Post, 구리기둥) 기술’을 세계 최초로 개발해 양산 제품 적용에 성공했다고 25일 밝혔다.
글로벌 주요 스마트폰 제조사들은 슬림화 경쟁이 치열하다. 스마트폰 부품 크기 최소화가 업계 화두다. RF-SiP(Radio Frequency-System in Package) 기판 등 모바일용 반도체 기판 성능을 고도화하면서 크기는 최소화할 수 있는 기술 수요가 급증하고 있다.
이 기술은 반도체 기판과 메인보드 연결 시 구리기둥(Cu-Post)을 활용하는 것이 핵심이다. 기존 방식 대비 더 많은 회로를 반도체 기판에 배치할 수 있고 반도체 패키지 열 방출에도 효과적이라고 한다. 모바일 제품 슬림화와 고사양화에 최적화한 기술로 업계 주목을 받고 있다. LG이노텍은 코퍼포스트 기술 확보로 글로벌 RF-SiP 기판 1위 입지를 더욱 공고히 할 수 있을 것으로 보고 있다.
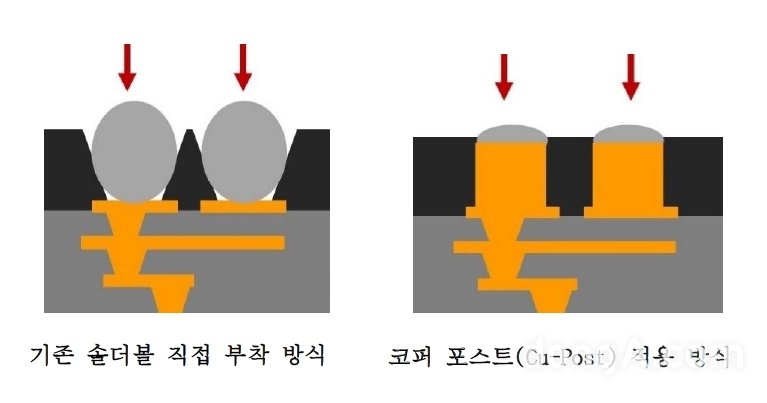
납땜구슬 대체하는 ‘구리기둥’ 기술… “간격·크기 축소 용이”
반도체 기판은 반도체 칩과 전력 증폭기, 필터 등 전자부품을 메인보드와 연결하는 제품이다. 납땜용 구슬인 솔더볼(Solder Ball)을 통해 메인보드와 연결돼 전기신호를 주고받는다. 솔더볼을 촘촘히 배열할수록 더 많은 회로를 연결할 수 있고 이는 스마트폰 성능을 향상시키는 핵심 요소로 꼽을 수 있다.기존에는 반도체 기판에 솔더볼을 직접 부착해 메인보드와 연결했다. 안정적인 접합을 위해 솔도볼 크기가 커야 했고 구 모양 구조로 인해 넓은 공간을 차지했다. 또한 간격이 좁으면 납땜 과정에서 녹은 솔더볼이 서로 달라붙는 현상이 발생하기도 했다. 이 방식으로는 솔더볼 간격을 줄여 회로 집적도를 높이는 것에 한계가 있었다.
LG이노텍은 이를 해결하기 위해 기존 제작 방식을 과감히 탈피하고 전에 없던 새로운 방식을 채용했다. 반도체 기판에 솔더볼을 직접 연결하는 대신 코퍼포스트 기술로 구리기둥을 먼저 세우고 그 위에 솔더볼을 작게 올리는 개념이다. 구리로 기둥을 세우는 것은 고난도 기술이라고 한다. LG이노텍은 디지털트윈(Digital Twin) 기반 3D 시뮬레이션 기술을 적극 활용해 개발 속도와 완성도를 동시에 끌어올렸다. 이를 통해 솔더볼 간격을 기존 대비 약 20% 가까이 줄이는 데 성공했다. 기둥 구조 최적화로 솔더볼 면적과 크기를 최소화했다. 또한 녹는점이 높은 구리를 사용해 고온 공정에서 기둥 형태가 안정적으로 유지돼 더욱 촘촘한 배열 설계가 가능해졌다.

회로 집적도↑… 발열 개선하면서 반도체 기판 소형화·고사양화
LG이노텍은 코퍼포스트 기술을 적용하면 기존과 동일한 성능을 구현하면서 크기는 최대 약 20% 작은 반도체 기판을 구현할 수 있다고 소개했다. 스마트폰 제조사는 슬림한 디자인 구현이 가능하고 설계 자유도를 높일 수 있다.스마트폰 발열 문제도 개선할 수 있다. 코퍼포스트에 사용된 구리는 납 대비 열전도율이 7배 이상 높아 반도체 패키지에서 발생하는 열을 보다 빠르게 외부로 방출한다. 열에 의한 칩 성능 저하나 신호 손실 등 관련 문제를 최소화해 모바일 기기 성능을 안정적으로 유지할 수 있다.

관련 특허 40여건 확보… “고객사 고민에서 시작해 업계 패러다임 전환”
LG이노텍은 코퍼포스트 기술 관련 특허 40여건을 확보하면서 독보적인 기술력을 갖추게 됐다. 이 기술을 모바일용 반도체 기판인 RF-SiP 기판, FC-CSP(Flip Chip-Chip Scale Package) 기판 등에 적용해 시장 우위를 강화해 나간다는 방침이다.문혁수 LG이노텍 대표는 “코퍼포스트 기술 개발은 단순히 부품 공급 목적이 아니라 고객 성공을 지원하기 위한 깊은 고민에서 시작됐다”며 “앞으로도 혁신 제품으로 기판업계 패러다임을 전환하면서 고객가치를 지속 창출해 나갈 것”이라고 말했다.
LG이노텍의 경우 RF-SiP와 FC-BGA 등 고부가 반도체 기판, 차량용 AP모듈 등을 주축으로 반도체용 부품 사업을 적극적으로 육성하고 있다. 오는 2030년까지 반도체용 부품 사업 분야 매출을 연간 3조 원 이상으로 끌어올린다는 계획이다.
© dongA.com All rights reserved. 무단 전재, 재배포 및 AI학습 이용 금지
트렌드뉴스
-
1
한동훈 제명 결정, 민주-국힘 지지층 모두 “잘했다” 더 많아
-
2
현대차 노조 “합의 없인 로봇 단 1대도 안돼”…‘아틀라스’에 위기감
-
3
법원 “이진숙 방통위 KBS 이사 7명 임명 무효”
-
4
장동혁 양지병원 입원…“단식 8일간 靑·여당 아무도 안왔다”
-
5
[단독]“권성동, ‘王’자 노리개 등 장식 상자 2개로 1억 받았다”
-
6
이정후 美공항서 일시 구금…前하원의장까지 나서 풀려났다
-
7
‘소득 있는 노인’ 노령연금 감액 안한다…월 519만원 미만 대상
-
8
박근혜 손잡고 울먹인 장동혁 “더 큰 싸움 위해 단식 중단”
-
9
[속보]홍익표 “李대통령, 장동혁 대표 병문안 지시…쾌유 기원”
-
10
홍익표 “李대통령, 장동혁 대표 병문안 지시…쾌유 기원”
-
1
수도권급 간-담도-췌장 수술 역량으로 지방 의료 살린다
-
2
박근혜 손잡고 울먹인 장동혁 “더 큰 싸움 위해 단식 중단”
-
3
한동훈 제명 결정, 민주-국힘 지지층 모두 “잘했다” 더 많아
-
4
“장동혁 의식 혼미, 심정지 가능성”…단식 8일째 구급차 대기
-
5
현대차 노조 “합의 없인 로봇 단 1대도 안돼”…‘아틀라스’에 위기감
-
6
장동혁 양지병원 입원…“단식 8일간 靑·여당 아무도 안왔다”
-
7
한덕수 징역 23년 선고…“위로부터의 내란, 위법성 더 크다”
-
8
李 “정교유착, 나라 망하는길…‘이재명 죽여라’ 설교하는 교회도”
-
9
[사설]한덕수 구형보다 크게 무거운 23년형… 준엄한 ‘12·3’ 첫 단죄
-
10
[김순덕 칼럼]팥쥐 엄마 ‘원펜타스 장관’에게 700조 예산 맡길 수 있나
트렌드뉴스
-
1
한동훈 제명 결정, 민주-국힘 지지층 모두 “잘했다” 더 많아
-
2
현대차 노조 “합의 없인 로봇 단 1대도 안돼”…‘아틀라스’에 위기감
-
3
법원 “이진숙 방통위 KBS 이사 7명 임명 무효”
-
4
장동혁 양지병원 입원…“단식 8일간 靑·여당 아무도 안왔다”
-
5
[단독]“권성동, ‘王’자 노리개 등 장식 상자 2개로 1억 받았다”
-
6
이정후 美공항서 일시 구금…前하원의장까지 나서 풀려났다
-
7
‘소득 있는 노인’ 노령연금 감액 안한다…월 519만원 미만 대상
-
8
박근혜 손잡고 울먹인 장동혁 “더 큰 싸움 위해 단식 중단”
-
9
[속보]홍익표 “李대통령, 장동혁 대표 병문안 지시…쾌유 기원”
-
10
홍익표 “李대통령, 장동혁 대표 병문안 지시…쾌유 기원”
-
1
수도권급 간-담도-췌장 수술 역량으로 지방 의료 살린다
-
2
박근혜 손잡고 울먹인 장동혁 “더 큰 싸움 위해 단식 중단”
-
3
한동훈 제명 결정, 민주-국힘 지지층 모두 “잘했다” 더 많아
-
4
“장동혁 의식 혼미, 심정지 가능성”…단식 8일째 구급차 대기
-
5
현대차 노조 “합의 없인 로봇 단 1대도 안돼”…‘아틀라스’에 위기감
-
6
장동혁 양지병원 입원…“단식 8일간 靑·여당 아무도 안왔다”
-
7
한덕수 징역 23년 선고…“위로부터의 내란, 위법성 더 크다”
-
8
李 “정교유착, 나라 망하는길…‘이재명 죽여라’ 설교하는 교회도”
-
9
[사설]한덕수 구형보다 크게 무거운 23년형… 준엄한 ‘12·3’ 첫 단죄
-
10
[김순덕 칼럼]팥쥐 엄마 ‘원펜타스 장관’에게 700조 예산 맡길 수 있나
-
- 좋아요
- 0개
-
- 슬퍼요
- 0개
-
- 화나요
- 0개



댓글 0